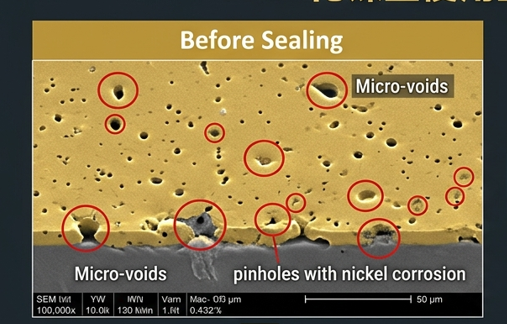
OSP、喷锡、化镍金,到底在解决什么问题?
相信很多人都会把 PCB 表面处理理解成“防氧化”,当然这样理解也没错,但这只是最表层的解释。
然而真正核心的问题是:
铜一旦发生氧化(Cu₂O / CuO),焊料就无法形成稳定的金属间化合物(IMC),焊点可靠性直接失效。
所以所有表面处理,不管采取哪种方式,其实本质都在解决一件事:
如何在“可焊性”和“可靠性”之间做平衡。当然选择什么样的表面处理,这是根据具体应用场景,具体需求而决定的。
我们在前面,提到过,PCB表面不做处理,那是不行的。像我这种做电子化学品的人,平时跟封孔剂、表面处理打交道比较多。今天不讲那些虚的概念,和大家一起探讨,表面处理的逻辑。
一、三种主流表面处理,本质区别是什么?
这种方式,可能是很多人都耳熟能详的表面处理方式,他的核心原理就是:直接在铜面覆盖一层较厚的锡层,形成物理隔绝。一句话相比其他方式,这种表面处理可以理解为简单粗暴,还便宜!
抗氧化能力强
成本低
不适合细间距(0.4mm 以下基本淘汰)
易桥连、虚焊
所以喷锡这种表面处理方式,只适合PCB中:低端、通孔、大间距的板,并不适合高密度设计。
其实每一种表面处理诞生都是因为之前的方式存在问题,去解决特定的问题而诞生的,OSP就是这种。这种表面处理方式的原理是:在铜表面形成一层有机络合膜,短时间内抑制氧化。为什说短时间抑制,是因为在回流焊的时候,这层保护膜就完成了他的使命,保护膜彻底消失,最后形成很好的焊接。
成本最低
工艺简单
一次回流后性能明显下降
对湿度、存储极其敏感
在实际的应用中:很多 OSP 板问题不是焊接,而是——还没上产线,已经氧化了,所以如果你是要保存时间久周转周期长,那就不适合这种方式。
综合来说,如果你是,适合快周转、单次回流、环境可控的情况,可以使用这种方式。
其实,出去这种,前面还有比如,沉锡,沉银,通常也说化锡,化银。化镍金后还有化镍钯金等,这里我们重点讲化镍金。这种表面处理方式是。在铜上面通过化学镀的方式形成一层镍合金层,然后在镍层上面通过置换反应形成一层金层。沉银:最大的敌人是空气中的硫,生成黑色的 Ag₂S(硫化银)。沉锡:最大的敌人是锡须和锡瘟。
结构分层:
• 镍层:提供机械强度 + 焊接界面
• 金层:防止镍氧化
可长期存储(6-12个月)
适合高可靠场景(通信/汽车)
本质:镍层被过度腐蚀,形成脆弱界面
导致掉件、焊点脆裂、间歇性失效
主要应用:高端方案,但对工艺控制要求极高。
二、一个很容易忽略的实际问题
👉 “既然 ENIG 最稳定,是不是直接用它就完了?”
存在即有道理,这种是不行的。原因很简单:
微孔缺陷 所有表面处理,都不是“致密层”存在微孔
ENIG 金层存在微孔(pinhole)
沉银/沉锡更容易发生反应
👉 意味着:水汽、硫、氧气,迟早会进去发生反应,形成氧化,腐蚀。
这种情况和其他不同的是,不是直接表现为焊不上,或者焊不稳的直观问题,而是一些隐藏问题。
典型场景:
• 盐雾测试不过
• 高温高湿后漏电流上升
• 沉银发黑
• 镍层被腐蚀
👉 所以这些隐形的问题,表面处理本身解决不了。
三、封孔剂在解决什么问题?
💡 封孔剂是在解决“缺陷填充”的问题,而不是在做“主结构”。让上面这些问题不再出现。
1. 填充微孔:阻断微观下的“腐蚀通道”
我们都知道化镍金在置换反应过程中,由于金原子和镍原子的尺寸差异,金层永远无法做到 100% 致密。这种情让空气,湿气有可能进入到和镍层甚至铜层发生反应,形成氧化,而封孔剂通过其长链分子纳米自组装成膜。从物理和化学双重维度阻断了空气、湿气进入镍层的通道,彻底切断了微电池效应带来的腐蚀。
2. 提升耐湿热能力
很多板子出厂时没问题,但在如果放在高温高湿的严苛条件下,很快就会出现问题。这种情况下金封孔剂尤其是针对化镍金工艺,它能极大降低“黑镍”效应带来的品质风险,让板子在潮湿环境下多出几倍的寿命。
3. 抗污染:提升制程中的“容错率”
这一点在实际生产中最为关键。工厂不是实验室,工人的手指印、空气中的硫化气体、车间的水汽,都是 PCB 的杀手。抗指纹:封孔后的板子,能有效抵抗操作过程中残留的汗渍和油脂。抗硫化:对于沉银工艺来说,封孔剂几乎是“救命稻草”,能防止银层在极短时间内变黑。降低了现场误操作导致的失效。
四、什么时候你需要封孔剂?
如果你追求的是极致的低成本,或者你的产品只用在普通的消费级电子设备上,或许可以不用。
但如果你的产品面临以下场景:
高盐雾要求:汽车电子、户外基站、航海设备。
长期存储:备件周期长,怕板子在仓库里“老”掉。
精密焊接:对 BGA 间距要求极高,绝不允许焊盘有微小氧化。
那么,请记得金面封孔剂就是为了解决这些问题而诞生的。封孔剂不改变主结构,它只负责把那最后 1% 的缺陷填满。而这可以给到消除那些你可能觉得莫名奇妙的问题。
—— 专业视角 · 从底层逻辑理解表面处理 ——